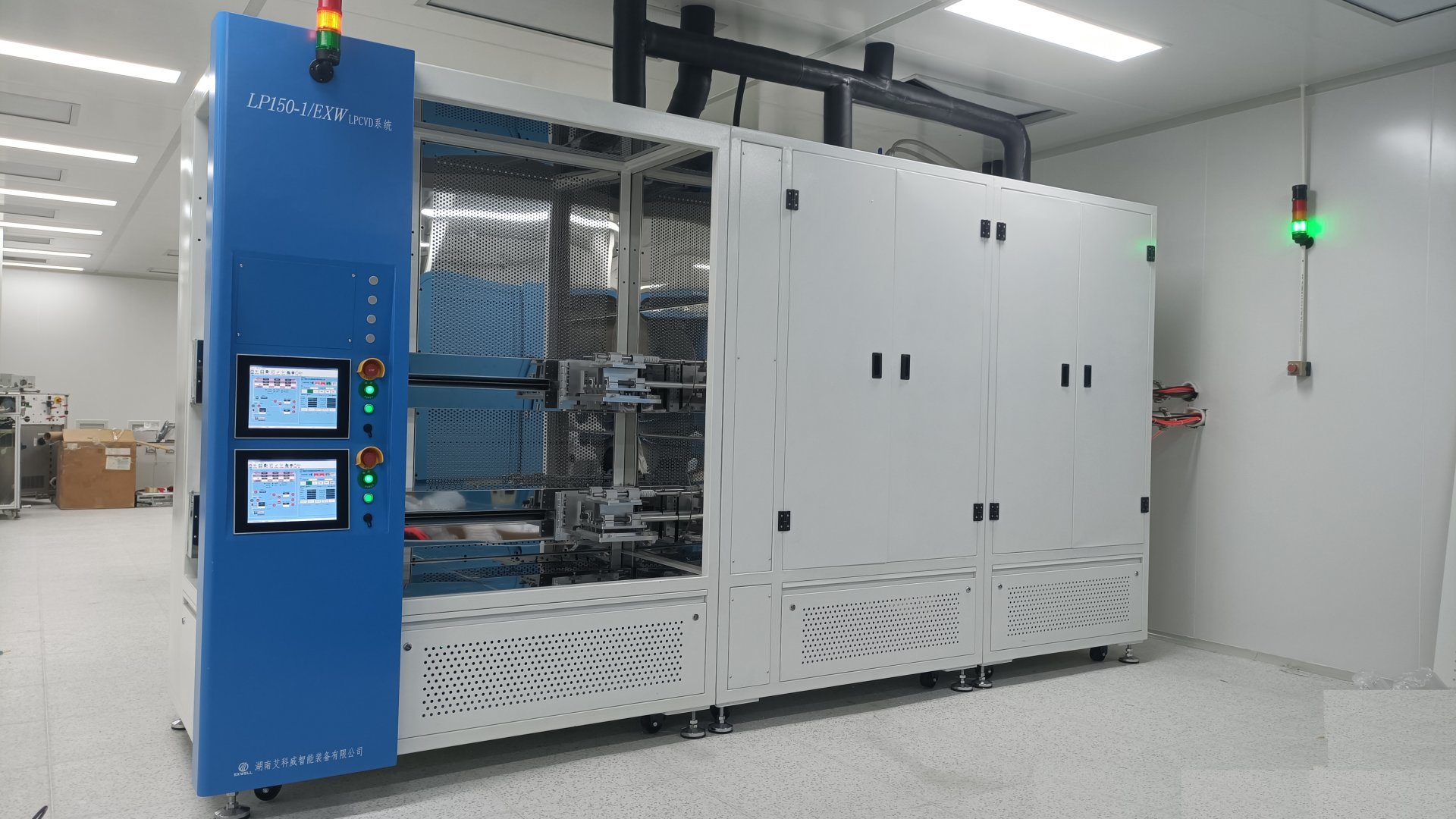

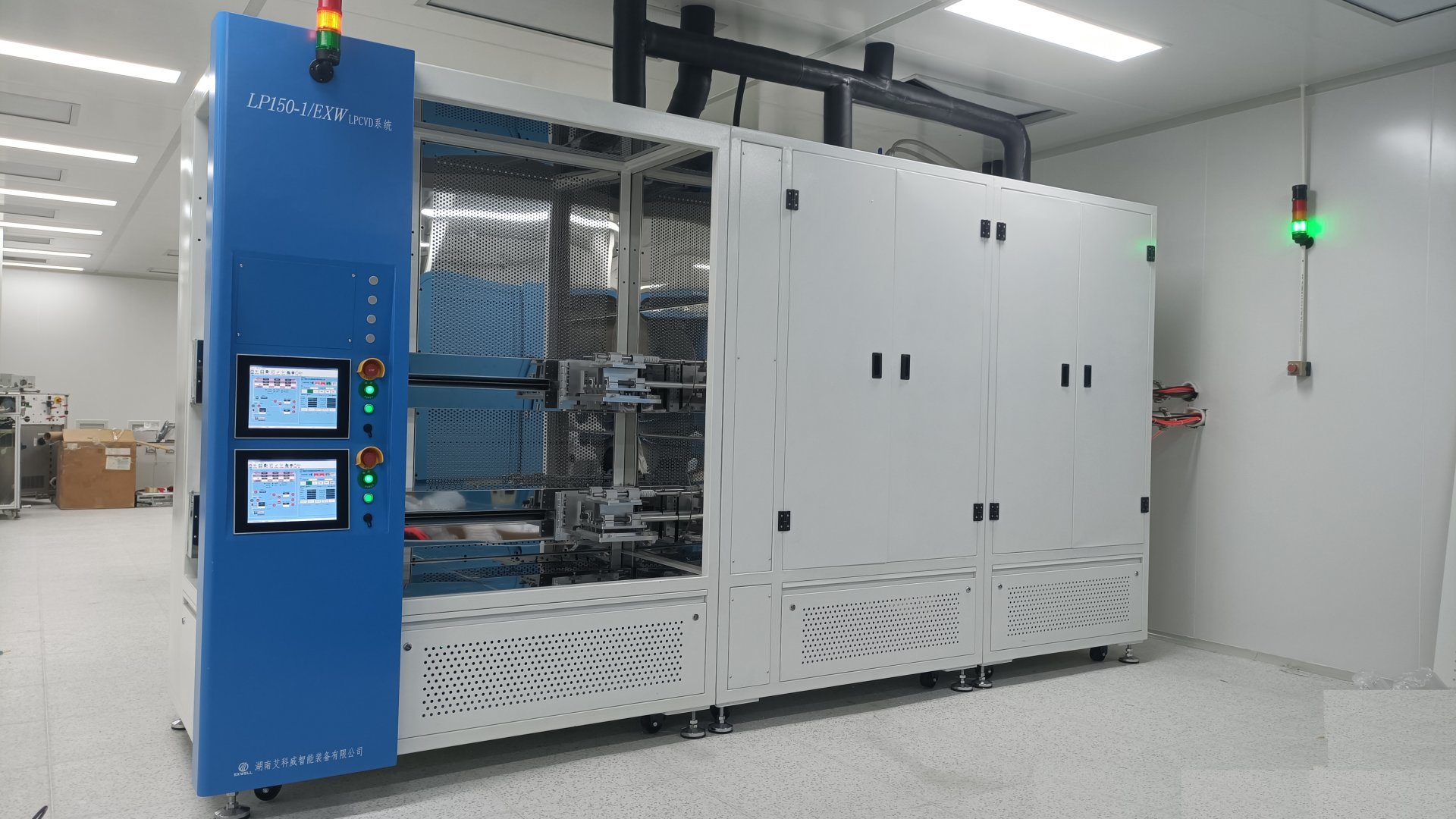

低压化学气相沉积设备( LPCVD)
LPCVD是用加热的方式在低压条件下使气态化合物在基片表面反应并淀积形成稳定固体薄膜。由于工作压力低,气体分子的平均自由程和扩散系数大,故可采用密集装片方式来提高生产率,并在衬底表面获得均匀性良好的薄膜淀积层。LPCVD用于淀积Poly-Si、Si3N4、SiO2、磷硅玻璃、硼磷硅玻璃、非晶硅及难熔金属硅化物等多种薄膜。广泛用于半导体集成电路、电力电子、光电子及MEMS等行业。

咨询热线:
设备特点
●温度控制采用串级控制方式,对基片实际温度进行实时智能控制。
●装载采用SiC悬臂桨,避免了与工艺管磨擦产生粉尘。
●反应气体分子送气和族射送气,避免气相反应产生粉尘和改善均匀性。
●工作压力闭环自动控制,提高工艺稳定性和重复性。
技术指标
●基片尺寸:4,6,8英寸圆片
●工作温度:500~900℃
●工艺管路:1~3管
●恒温区长度:400mm~800mm
●控温精度:±0.5℃
●极限真空度:<1Pa
●膜厚均匀性:Si3N4:±3%; Poly-Si:±4%; TEOS-SiO2:±3%
应用范围
用于半导体器件、电力电子器件、光电子等行业氮化硅、多晶硅或氧化硅薄膜的制备
产品推荐
在线留言
全国热线电话
0731-88376310
地址:长沙市望城经济技术开发区普瑞西路858号
手机:13574134080(李经理)15111237996(戴经理)13337218692(陈经理)
传真:0731-88376310

客服热线
客服热线
0731-88376310
关注我们

微信咨询
- 返回顶部


